研究人员设计出比DDR5快30倍的3D DRAM
东京工业大学的科学家们设计出一种新型3D DRAM栈,其顶部配有处理器,可提供比高带宽内存(HBM)高出四倍的传输带宽与仅五分之一的访问功耗。
HBM通过中介层将小型DRAM栈接入至CPU,从而避开了受到CPU限制的DRAM插槽数量。在Bumpless Build Cube 3D(简称BBCube3D)概念中,单个DRAM芯片通过微凸块(连接器)与上方或下方的芯片相连,而连接孔(通过硅通孔,即TSV)穿过芯片将各个微凸块连接起来。
研究团队负责人Takayuki Ohba教授表示,“BBCVube 3D拥有良好的性能潜力,可实现每秒1.6 TB理论传输带宽,相当于DDR5的30倍、HBM2E的4倍。”
研究人员们削薄了每个DRAM芯片,同时消除了BBCube3D晶圆叠层(WOW)设计中的微凸块。与DDR5或HBM2E(第二代高带宽扩展内存)设计相比,这种新方案使得内存块拥有更高速度和更低的运行能耗。这是因为前者的运行温度更高,而且凸块的存在会增加电阻/电容和延迟。
HBM微凸块还会占用空间,且芯片的硬度也必须达标,否则无法承受堆叠层合并所带来的压力。通过消除微凸块,每个内存芯片都可以变得更薄、硅通孔更短,从而实现带好的散热效果。BBCube3D设计还不需要中介层,因为处理单元、CPU或GPU能够直接绑定至缓存芯片,而缓存芯片本身又可绑定至DRAM栈的顶端。
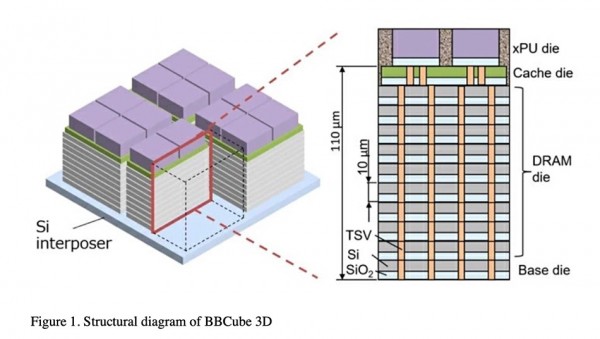
研究人员们解释道,“更短的硅通孔互连能够为CPU和GPU等高温设备提供更好的散热……高密度硅通孔本身就可以充当热管,因此即使是在3D结构当中,其预期运行温度也会更低。”
“由于硅通孔长度更短且信号并行度更高”,BBCube“能够实现更高带宽与更低运行功耗”。
通过调整相邻IO线的时序来确保其彼此异相,研究人员还成功减少了分层DRAM中的串扰。这种方法被称为四相屏蔽输入/输出,意味着IO线永远不会与其紧邻的线路同时发生值变化。
下图所示,为BBCube与DDR5和HBM2E内存技术的速度与能耗比较。可以看到,其带宽达到DDR5内存的32倍,速度相当于HBM2E的4倍。与此同时,BBCube 3D设计还实现了比DDR5和HBM2E更低的访问能耗水平。
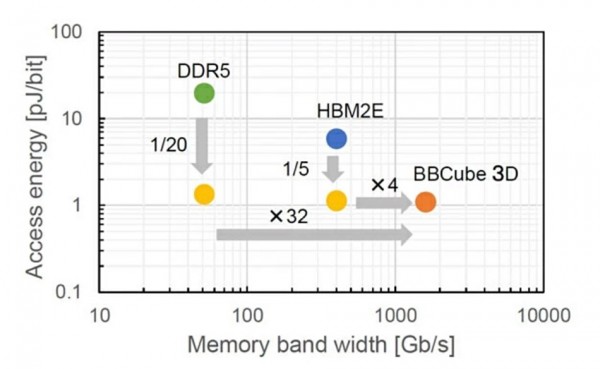
Ohba解释道,“由于BBCube的热阻和阻抗都更低,所以能够缓解3D集成设计中经常出现的热管理和电源问题。此次提出的新技术能够在达成可观传输带宽的同时,将每bit访问功耗降低至DDR5的二十分之一和HBM2E的五分之一。”
BBCube 3D属于高校主导的研究项目。关于该项目的详细背景信息,可以在MDPI Electronics论文《论使用晶圆上晶圆(WoW)与晶圆上晶片(CoW)实现兆级三维集成(3DI)的BBCube》(https://www.mdpi.com/2079-9292/11/2/236)中找到。论文提到,“BBCube允许将堆叠的芯片数量提升至HBM的4倍,意味着使用16 Gb DRAM裸片时内存容量可以达到64 GB。”
文章同时指出,“通过堆叠40层DRAM,即可实现Tb级别的3D内存。”
论文《Bumpless Build Cube (BBCube) 3D:使用WoW与CoW的异相3D集成实现TB/s级传输带宽与最低bit访问功耗》(Bumpless Build Cube (BBCube) 3D: Heterogeneous 3D Integration Using WoW and CoW to Provide TB/s Bandwidth with Lowest Bit Access Energy)对BBCube 3D概念也做了描述,文章发表于2023年6月的IEEE 2023 VLSI技术与电路研讨会。
好文章,需要你的鼓励
Glean年收入突破3亿美元,削减AI成本成核心卖点
企业AI搜索公司Glean宣布年度经常性收入(ARR)达3亿美元,较15个月前的1亿美元增长三倍。尽管谷歌、微软、OpenAI等科技巨头纷纷入局企业AI搜索市场,Glean凭借"上下文图谱"技术深度理解企业业务需求,并帮助客户显著降低AI计算成本。该公司提供按用量计费和混合定价两种模式,客户涵盖Databricks、Reddit、Pinterest及三星等企业。Glean上轮融资后估值达72亿美元。
香港中文大学与MiniMax联手破解AI图像描述的“说多错多、说少漏多“困局
香港中文大学与MiniMax提出ClaimDiff-RL框架,将图像描述的AI训练从整体打分升级为逐条核查,有效解决了传统方式导致AI"少说保平安"的问题,同时在多项基准测试上超越Gemini-3-Pro-Preview。
蓝色起源“新格伦“火箭在佛罗里达测试中发生爆炸
杰夫·贝索斯旗下的蓝色起源公司在佛罗里达卡纳维拉尔角进行静态点火测试时,新格伦重型火箭发生爆炸。这是美国历史上最大规模的火箭爆炸之一,也是蓝色起源公司遭遇的最严重失败。所有人员安全,但该事故可能导致新格伦火箭项目长期暂停。此前该火箭已成功完成三次发射,并实现了助推器回收和重复使用。
NTU、HKU等多所顶校联手,让AI同时“多角度看片“——视频理解的并行探针革命
ParaVT是一个由南洋理工等多校联合提出的并行视频工具调用框架,通过让AI同时分析多段视频并引入PARA-GRPO算法解决训练中的格式崩溃与工具跳过问题,在六项长视频理解测试中平均提升约7.9%。
Glean年收入突破3亿美元,削减AI成本成核心卖点
蓝色起源"新格伦"火箭在佛罗里达测试中发生爆炸
智能体AI正在重塑企业架构与Token经济学
堪培拉理工学院如何借助技术革新重塑课堂教学体验
Gemma 4携手Arm:优化端侧AI,加速移动应用体验
制药公司与初创企业如何携手推动AI落地
《星球大战》导演盛赞生成式AI:电影制作的革命性工具
Salesforce借助Informatica布局企业级无头数据管理架构
几乎所有M5 MacBook Air配置现在都降价近200美元
大模型评测风向变了,Testin云测如何构建企业级AI质量标尺?
因民事养老金管理失误,英国政府拒绝向Capita授予5.63亿英镑合同
YouTube提升AI生成视频标签的显示效果







