HBM、HBM2、HBM3和HBM3e技术对比

HBM即高带宽存储,由多层DRAM Die垂直堆叠,每层Die通过TSV穿透硅通孔技术实现与逻辑Die连接,使得8层、12层Die封装于小体积空间中,从而实现小尺寸于高带宽、高传输速度的兼容,成为高性能AI服务器GPU显存的主流解决方案。
目前迭代至HBM3的扩展版本HBM3E,提供高达8Gbps的传输速度和16GB内存,由SK海力士率先发布,将于2024年量。
HBM主要应用场景为AI服务器,最新一代HBM3e搭载于英伟达2023年发布的H200。根据Trendforce数据,2022年AI服务器出货量86万台,预计2026年AI服务器出货量将超过200万台,年复合增速29%。
AI服务器出货量增长催化HBM需求爆发,且伴随服务器平均HBM容量增加,经测算,预期25年市场规模约150亿美元,增速超过50%。
HBM供给厂商主要聚集在SK海力士、三星、美光三大存储原厂,根据Trendforce数据,2023年SK海力士市占率预计为53%,三星市占率38%、美光市占率9%。HBM在工艺上的变化主要在CoWoS和TSV。
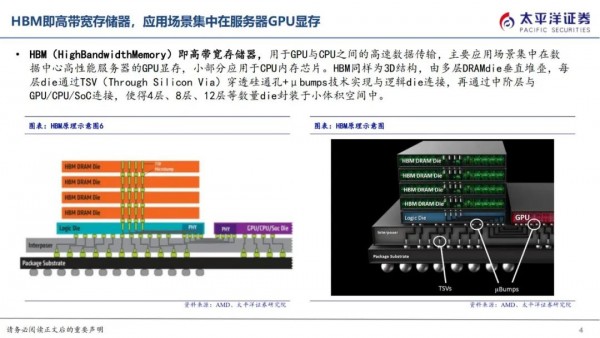

HBM1最早于2014年由AMD与SK海力士共同推出,作为GDDR竞品,为4层die堆叠,提供128GB/s带宽,4GB内存,显著优于同期GDDR5。

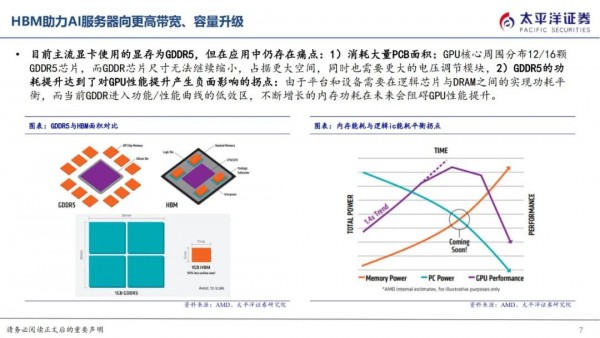
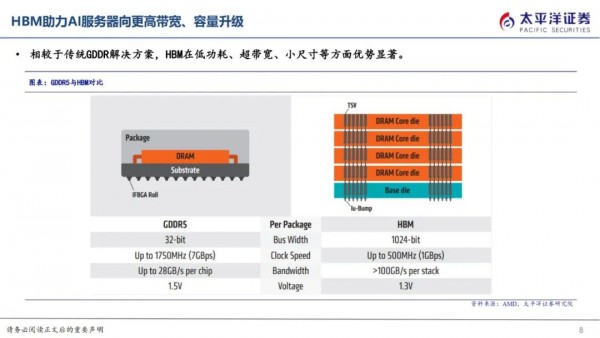
HBM因其高带宽、低功耗、小体积等特性,广泛应用于AI服务器场景中。HBM的应用主要集中在高性能服务器,最早落地于2016年的NVP100GPU(HBM2)中,后于2017年应用在V100(HBM2)、于2020年应用在A100(HBM2)、于2022年应用在H100(HBM2e/HBM3),最新一代HBM3e搭载于英伟达2023年发布的H200,为服务器提供更快速度及更高容量。
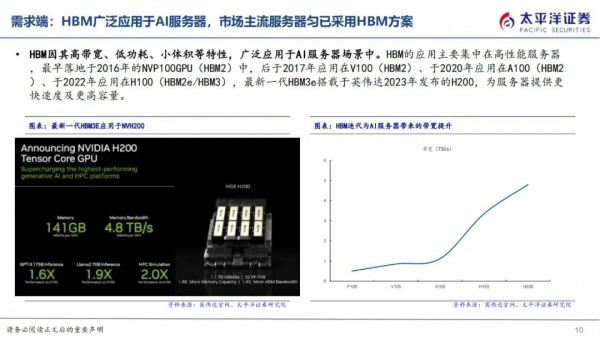
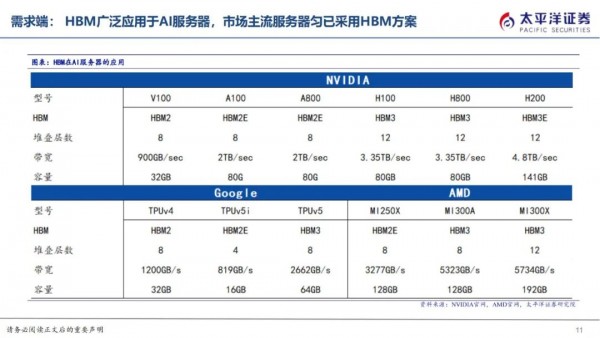

HBM供给厂商主要聚集在SK海力士、三星、美光三大厂,SK海力士领跑。三大存储原厂主要承担DRAMDie的生产及堆叠,展开技术升级竞赛,其中SK海力士与AMD合作发布全球首款HBM,23年率先供应新一代HBM3E,先发奠定市场地位,主要供应英伟达,三星供应其他云端厂商,根据TrendForce数据,2022年SK海力士市占率50%、三星市占率40%、美光市占率10%左右,2023年SK海力士市占率预计为53%,三星市占率38%、美光市占率9%。
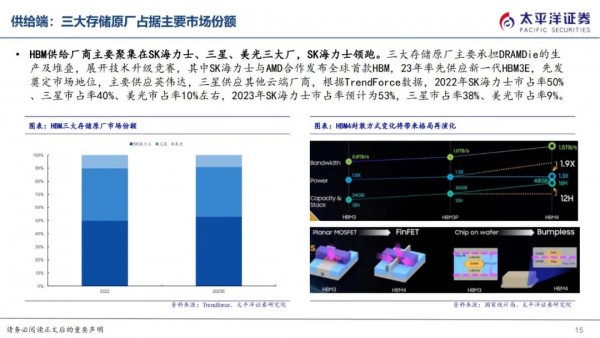
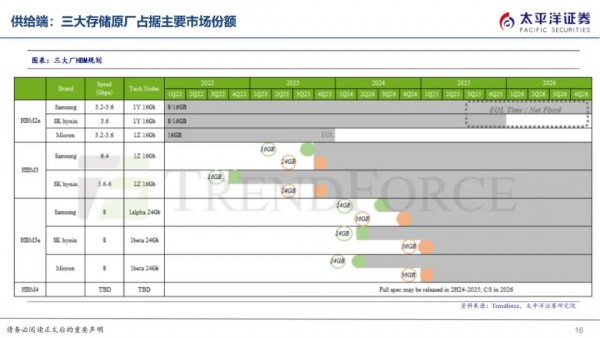
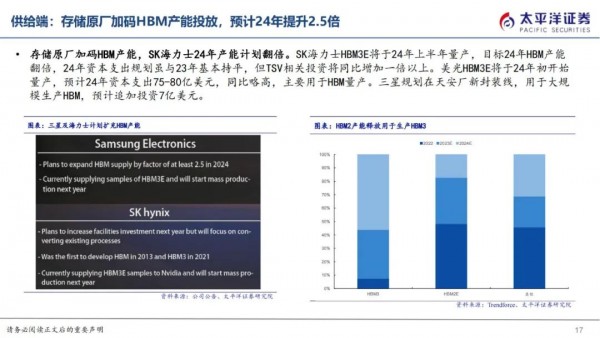
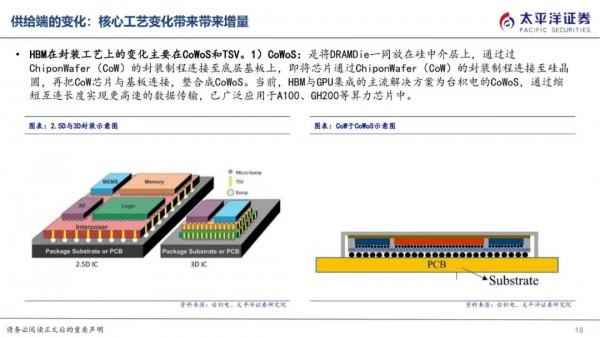
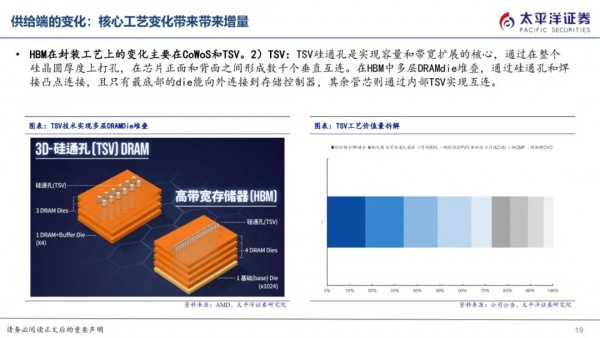
HBM在封装工艺上的变化主要在CoWoS和TSV。
1)CoWoS:是将DRAMDie一同放在硅中介层上,通过过ChiponWafer(CoW)的封装制程连接至底层基板上,即将芯片通过ChiponWafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板连接,整合成CoWoS。当前,HBM与GPU集成的主流解决方案为台积电的CoWoS,通过缩短互连长度实现更高速的数据传输,已广泛应用于A100、GH200等算力芯片中。
2)TSV:TSV硅通孔是实现容量和带宽扩展的核心,通过在整个硅晶圆厚度上打孔,在芯片正面和背面之间形成数千个垂直互连。在HBM中多层DRAMdie堆叠,通过硅通孔和焊接凸点连接,且只有最底部的die能向外连接到存储控制器,其余管芯则通过内部TSV实现互连。
好文章,需要你的鼓励
AI助手越权了?南加州大学等机构揭示大模型代理的“权限失控“问题
FORTIS是专门测量AI代理"越权行为"的基准测试,研究发现十款顶尖模型普遍选择远超任务需要的高权限技能,端到端成功率最高仅14.3%。
谷歌向“AI优先“智能手机迈出关键一步
谷歌在Android Show发布会上宣布,将Gemini更深度整合至Android系统,推出名为"Gemini Intelligence"的升级功能。该功能可跨应用处理日常任务,包括自动填写表单、安排日程、生成购物清单及自定义小组件等,无需用户频繁切换应用。此外,Gboard新增"Rambler"功能,可自动过滤语音输入中的口误和填充词。Gemini Intelligence将率先登陆三星Galaxy和谷歌Pixel手机,并支持Android Auto、Wear OS及智能眼镜。
荷兰Nebius团队:给AI“起草员“瘦身,大模型推理速度最高提升5倍的秘密
荷兰Nebius团队提出SlimSpec,通过低秩分解压缩草稿模型LM-Head的内部表示而非裁剪词汇,在保留完整词汇表的同时将LM-Head计算时间压缩至原来的五分之一,端到端推理速度超越现有方法最高达9%。







